반도체 공정 - (3) - 2 포토 공정(장비, Parameters)
공정 장비
Mask
Photomask: 석영(빛 투과 area) 기판 위에 크롬(빛 차단 area) 막을 증착해 제작
조건 -> 낮은 열팽창계수, 높은 석영 투과율, 높은 크롬 차단율
Mask vs Reticle: Mask는 하나의 석영 기판에 1개의 패턴, Reticle은 4개의 패턴 존재, 최근에는 잘 구분하지 않음
-> Reticle은 크기를 4배 키우면서 particle에 의한 defect를 1/4로 줄임
또한, 크게 만드므로 단가, 난이도 감소

Track & Stepper
Track(in-line): vapor prime, resist coat, develop, bake와 같은 공정을 하나의 장비에서 모두 진행
Stepper(Scanner): Track에서 transfer station을 통해 wafer를 받아 Alignment와 Exposure 진행
=> wafer의 동선을 줄여 생산성 증가
Stepper vs Scanner
| Stepper | Scanner | |
| 노광방법 | 고정하여 노광 다음 위치로 이동 후 노광 반복 |
이동하며 노광 Reticle과 Wafer가 서로 반대방향으로 이동하며 Scan |
| 특징 | 1. Step & Repeat 2. 단일 샷 -> 큰 렌즈 필요 |
1. Scan & Repeat 2. 연속된 샷 -> 작은 렌즈 가능 |

Exposure type
| Contact Aligner | Proximity Aligner | Projection Aligner | |
| Figure |  |
 |
 |
| 방식 | PR과 마스크를 붙인 후 노광 | PR과 마스크 사이에 공간을 약간 두고 노광 | PR과 마스크 사이에 렌즈를 넣어 회절된 빛을 모아 노광 |
| 특징 | PR과 마스크가 직접적으로 붙었다 떨어지기를 반복하기 때문에 마스크 교체를 자주 해야하고 Defect 발생 | PR과 마스크 사이에 공간이 있으므로 회절이 발생해 정확한 패턴 구현 불가능 | 마스크 교체 주기도 길고 회절을 최소화 시켜 정확한 패턴 구현 가능 => 주로 사용 |
Antireflective Coating(ARC)
ARC: 노광 공정 시 반사파로 인해 원치 않는 노광과 정상파 발생 방지
빛을 잘 흡수해야하며, 노광 공정 이후에 제거가 용이해야함
Bottom ARC -> substrate reflection 방지
Top ARC -> secondory reflection 방지

Pellicle
Pellicle: 포토 마스크에 씌워져 오염물질로 부터 방어하는 역할, 높은 투과율 필요
-> 포토 마스크 수명 증가, Defect 감소
공정 Parameters
Resolution & DOF
NA(Numerical Aperture): 렌즈가 클 수록 NA 값 증가 및 회절된 빛을 더 잘 모음
NA=렌즈 반지름/초점거리

CD(Critical Dimension): 최소 선폭

λ가 작고 NA가 클수록 더 작은 CD 구현 가능
-> 미세 선폭 구현 가능
Resolution: 주변 패턴과 구분가능한 최소 dimension of linewidth => 값이 작을 수록 좋음

Better Resolution: λ 감소 -> 더 짧은 파장의 광원 사용
NA 증가 -> 더 크고 성능이 좋은 렌즈 사용
k1 감소 -> 공정 또는 PR 개발

DOF(Depth Of Focus): 초점심도로, 초점을 맞출 수 있는 범위 => 값이 클 수록 초점 허용범위가 넓어지므로 좋음


λ증가, NA감소, k2 증가할 수록 DOF 증가
=> Resolution 식과 유사 but, 성능 면에서 Resolution과 DOF는 반비례
반도체 산업에서는 더 작은 선폭을 만들어야 하므로, Resolution을 증가시키는 방향으로 기술 발전
DOF도 같이 증가되지만 CMP를 통해 표면을 굉장히 flat하게 만들어 초점을 정교하게 맞추며 issue해결
Overlay
Overlay: Mask와 wafer의 수평 및 수직 방향 정렬도를 나타내는 수치
Errors: Shift or Translation, Wafer magnification or scale, Rotation, Shot magnification
Aspect Ratio & Step coverage (PR)
Aspect Ratio: 구조물의 너비 대비 깊이를 나타내는 지표 -> 높을 수록 고도의 기술력 요구
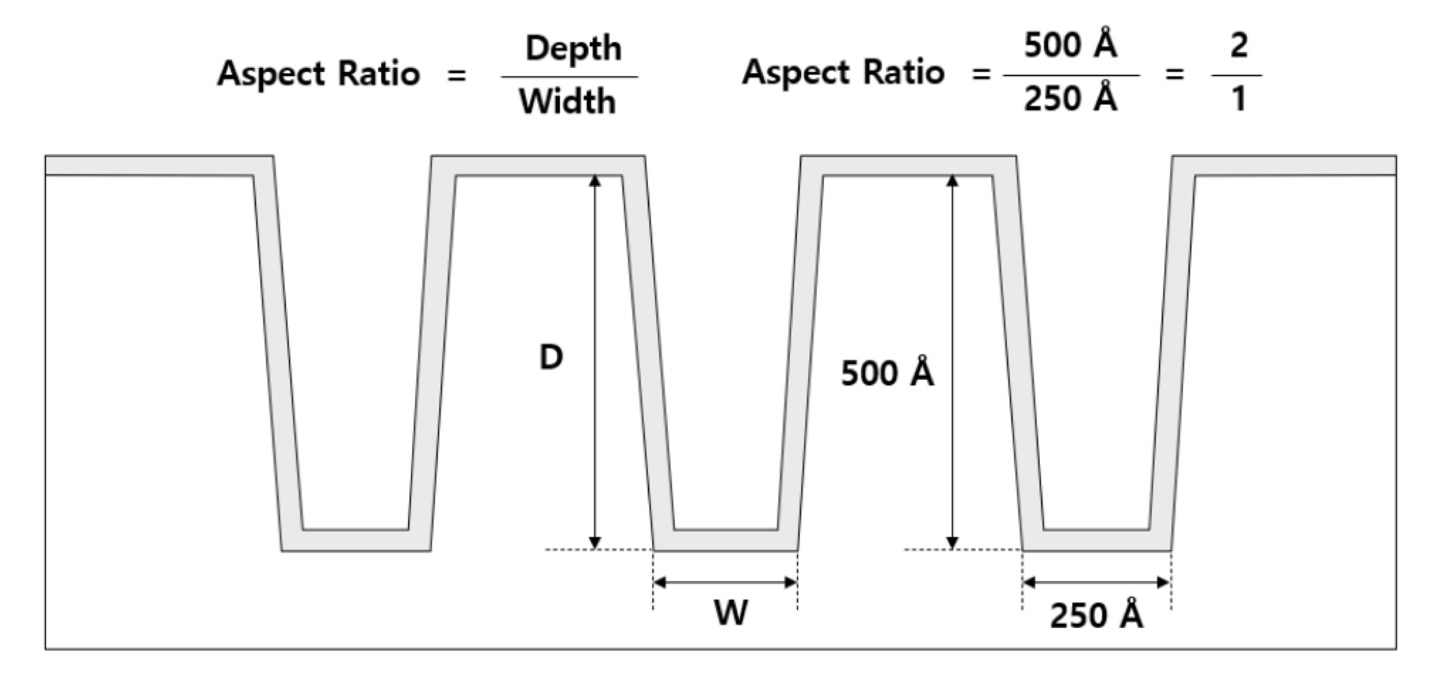
Step coverage: 단차 피복으로, 위치에 따른 두께차이를 나타내는 척도(옆면과 밑면)
