증착 공정: 반도체 공정에서 필요한 특성을 갖는 박막을 쌓아 올리는 공정
과정: nucleation -> nuclei(island growth) -> continuous film
gas molecule이 substrate에 adsorption되어 돌아다님
다른 molecule과 부딪히고 서로 뭉치며 nucleation됨
박막에 고정돼 성장해 island가 되고 다른 island와 합쳐짐
균일한 continuous 박막 형성
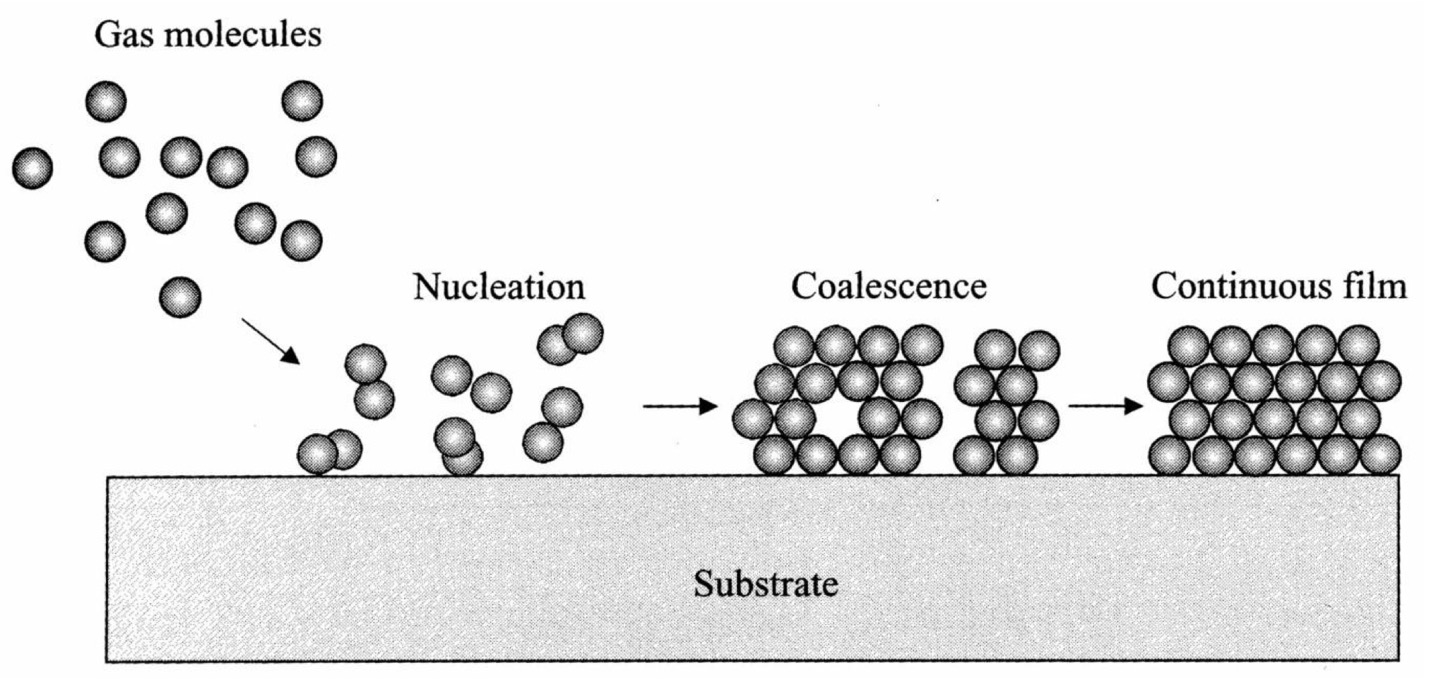
증착 parameter
Step Coverage
: profile의 수평 방향 대비 수직 방향 증착 두깨 비율


Aspect Ratio
: trench 혹은 via의 너비 대비 깊이 => high aspect ratio일 수록 균일한 증착이 어려움


PVD(Physical Vapor Deposition)
(Thermal) Evaporation
: source 물질이 진공 챔버에서 열 에너지 혹은 electron beam에 의해 증발되어 기판에 증착
*step coverage와 기판과의 adsorption이 좋지 않아 잘 사용하지 않음

Sputtering
: 플라즈마 이온이 target source에 부딪히며 떨어져 나온 물질이 기판에 증착
*주로 metal 증착에 사용

CVD(Chemical Vapor Deposition)
(PE)CVD: Plasma-Enhanced CVD, plasma dry etch와 같은 공정 과정, but gas 종류가 다름
과정
1. gas주입, plasma에 의해 precursor와 byproduct 생성
2. precursor가 기판에 붙어 diffusion하다가 nucleation 및 nuclei
3. 반복되며 박막이 continuous 성장

Plasma의 사용 유무, Plasma 세기, 압력의 정도에 따라 다양한 종류의 CVD 존재
| 구분 | 장점 | 단점 | 용도 |
| APCVD(Atmospheric Pressure CVD) | 저렴, 빠른 증착 속도 | Step coverage 나쁨 | 평평한 산화막 |
| LPCVD(Low Pressure CVD) | 고품질 필름 | 고온, 느린 증착 속도 | Poly-Si, SiO2, Si3N4 |
| PECVD(Plasma-Enhanced CVD) | 저온, 빠른 증착 속도 | 저품질 필름 | IMD(Inter Metal Dielectric), Passivation |
| HDPCVD(High-Density Plasma CVD) | Gap filling 특성 우수, 저온, 고품질 |
플라즈마 데미지 | Shallow Trench, Isolation(STI), IMD |
| ALD(Atomic Layer Deposition) | 고품질, step coverage 우수 | 낮은 생산량 | 게이트 유전막, Interconnect |
공정속도: 표면으로의 반응 물질 전달 속도 vs 표면 반응속도 => 더 느린 속도에 따라 정해짐
Mass Transport Limited: 물질 전달 속도 < 표면 반응 속도
반응 온도가 높아 반응 속도가 충분히 높음 => 물질 전달 속도에 따라 공정 속도 결정됌
*Chamber design 중요
Reaction Rate Limited: 물질 전달 속도 > 표면 반응 속도 (LPCVD: 압력이 낮아 물질 전달 속도 매우 빠름)
반응온도가 낮아 반응 속도가 낮음 => 물질 반응 속도에 따라 공정 속도 결정됌
*반응 온도에 민감하므로 온도 control 중요

ALD(Atomic Layer Deposition): SLG(Self-Limiting Deposition)을 이용해 atomic layer를 한 층 한 층 쌓아 나가는 증착 공정
*SLG: 한정된 개수의 반응기로 인해 증착 입자 개수를 제한함
과정
1. Precursor A 주입, 기판에 chemisorption, physisorption
2. Purging => physisorped precursor 제거
3. Precursor B 주입, chemisorption, physisorption
4. Purging => physisorped precursor 제거

'반도체 전공정 기본' 카테고리의 다른 글
| 반도체 공정 - (6) 금속 배선 공정 (0) | 2024.07.30 |
|---|---|
| 반도체 공정 - (5) 도핑 공정 (0) | 2024.07.16 |
| 반도체 공정 - (4) - 2 식각 공정(물질 별 식각) (0) | 2024.07.11 |
| 반도체 공정 - (4) - 1 식각 공정(Parameters, Plasma Dry Etch) (0) | 2024.07.10 |
| 반도체 공정 - (3) - 2 포토 공정(장비, Parameters) (0) | 2024.07.08 |