포토공정(Photolithography -> photo(빛) + litho(돌) + graphy(그림,글자) = photolithography(빛으로 패턴형성)
목적: photoresist(PR) mask patten을 형성해 후속공정(Etch, Ion implantation, Deposition)에서 보호막 역할
포토 공정 과정

1) (Vapor) Prime: 웨이퍼를 세척, 건조 및 PR의 adhesion을 높이는 물질(HMDS: [Si(CH3)3]2NH)로 웨이퍼 도포
보통 웨이퍼 표면이 친수성이고 PR이 소수성이므로 소수성인 HMDS를 도포해줌
HMDS 도포 방식 (1) Puddle dispense and spin: 휘저으며 분배 및 스핀코팅
온도, 두께 조절 용이 but HMDS 사용량 많음
(2) Spray dispense and spin: 스프레이로 분사 후 스핀코팅
미세 입자 사용으로 균일도 증가, 결함 감소
but HMDS 사용량 많고 시간이 오래걸림
(3) Vapor prime: 증기 형태로 웨이퍼 도포 -> 접촉(오염)최소화, HMDS사용량 최소화
현재 많이 사용, 온도 가열하며 HMDS gas 주입, 반응 후 N2 purging
2) Spin Coat: PR을 웨이퍼 위에 뿌리고 웨이퍼를 빠르게 돌려 원심력에 의해 PR이 퍼지며 코팅
PR 두께는 spin rpm으로 결정(rpm증가 -> 두께 감소, rpm감소 -> 두께 증가)
평가요소 -> 두께, Uniformity, Defects
but, spin coating은 재료를 많이 소비하는 공정 -> 반도체는 부가가치 높은 산업이므로 감당하며 사용
3) Soft Bake: 90~100°C에서 30초간 열처리 -> PR의 solvent를 증발시키고 PR의 adhesion을 높임
저온에서는 Solvent가 완벽히 제거되지 않고, 고온에서는 PR이 열에 반응할 수 있으므로 온도 제어 필요
4) Alignment and Exposure: Photomask와 웨이퍼 위치를 알맞게 align시킨 후 노광시켜 target area의 PR을 반응시킴
5) Post-Exposure Bake(PEB): 노광 후 100~120°C에서 열처리 -> 빛 간섭으로 PR 표면에 생긴 물결무늬를 평탄화 시킴
제거하지 않으면 정확한 Etch 불가능
6) Develop: 현상액에 담궈 노광된 부분 or 노광되지 않은 부분을 용해시켜 제거
Negative PR -> 노광돼 딱딱해진 PR을 제외한 부분을 제거
Positive PR -> 노광돼 물렁해진 PR을 제거
7) Hard Bake(Post-Develop Bake): 130~150°C에서 열처리 -> 잔여 solvent, developer를 제거, resist를 더 단단하게 만듦
8) Develop Inspect: Defect, particle, CD(Critical Dimension), Resolution, Overlay, Contrast 검사
Photoresist(PR)
Negative PR: Mask 모양과 반대(negative) 모양의 패턴 형성 -> mask를 통과한 빛이 PR과 반응(Cross linked)해 단단해짐
Positive PR: Mask 모양의 패턴 형성 -> mask를 통과한 빛이 PR과 반응(Soluble)해 물렁해짐
| 특성 | Positive PR | Negative PR |
| Si wafer adhesion | 양호 | 좋음 |
| 단가 | 비쌈 | 저렴 |
| 현상액 기반 | 수성 | 유기물 |
| 현상액에 대한 용해성 | 노출된 영역 용해 | 노출된 영역 불용해 |
| 최소 CD | 0.5um | 2um |
| Step coverage | 좋음 | 낮음 |
| Etch resist | 양호 | 우수 |
Negative PR은 노광되면 부푸는 현상 발생(Swelling)으로 pattern이 변함 -> 치명적인 단점
광원이 i-line(365nm) -> DUV(Deep Ultra Violet, 193nm) -> EUV(Extreme Ultra Violet, 13.5nm)로 바뀌며 PR도 바뀜
해당 파장 영역에서 Sensitive한 PR 종류가 다름
1) i-line PR -> Resin, Sensitizer, Solvent, Additives로 구성
* Resin은 고분자 물질로 PR이 adhesion, etch resistance, thermal stability 특성을 갖음
Sensitizer는 빛에 민감한 물질로 빛과 반응해 반응 물질을 생성
Solvent는 Resin과 Sensitizer가 균일하게 분산시킴
Additive는 화학 반응을 조절해줌
Negative i-line PR: UV를 받으면 Sensitizer가 free radical을 생성해 resin이 cross link하게 만듦
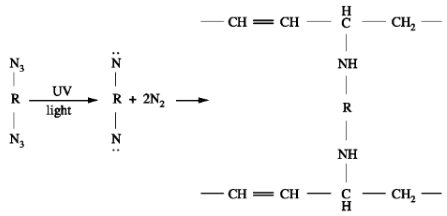
Positive i-line PR: UV를 받기전 Sensitizer가 dissolution inhibitor역할, UV를 받으면 Resin의 용해를 촉진
* Resin: Novolak / Sensitizer(PAC, Photoactive Compound): DNQ

위 그림처럼 노광 전 DNQ가 Novolak의 용해도를 낮췄다가 노광 후 용해도를 높임
2) DUV PR: 화학 증폭형 PR(Chemical Amplification, CA) -> Sensitizer로 PAG(Photo Acid Generator)를 사용
PAG는 DUV에 반응해 acid를 생성하고, 이 acid가 PEB단계에서 protecting group을 제거
Acid가 protecting group을 제거할 때 다시 acid가 생성되고 이 acid가 다른 group을 제거하며 연쇄반응
but, 연쇄반응으로 중간에 Addictie(Base)를 넣어 중단

3) EUV PR: CA의 한계로 새로운 PR 등장, non-CAR(Chmical Amplified Resist) PR -> Impria Resist
Core-Shell 구조로, 노광 전 Shell에 있는 ligand들이 척력을 만들어 서로 안뭉치게함
노광 후 ligand가 떼어지면서 Core끼리 뭉쳐 단단해짐 -> Negative PR

'반도체 전공정 기본' 카테고리의 다른 글
| 반도체 공정 - (4) - 1 식각 공정(Parameters, Plasma Dry Etch) (0) | 2024.07.10 |
|---|---|
| 반도체 공정 - (3) - 2 포토 공정(장비, Parameters) (0) | 2024.07.08 |
| 반도체 공정 - (2) 산화막 공정 (1) | 2024.06.08 |
| 반도체 공정 - (1) 웨이퍼 공정(웨이퍼 제조) (0) | 2024.06.05 |
| 반도체 공정 - (1) 웨이퍼 공정(클리닝) (0) | 2024.05.31 |